專注於膠(jiāo)粘劑的研發製造
在電子封裝領域,芯片底部填充膠(Underfill)作為一種重要的集成(chéng)電路封(fēng)裝電子膠黏劑,發揮著至關重要的作用。它主要用於在(zài)芯片和基板之間的空隙中填充,能夠有效緩解芯片封(fēng)裝中不同材料之間熱膨脹係數不匹配帶來的應力集(jí)中問題,進而提高器件封裝可(kě)靠性,增強芯片與基板之間的連接強度(dù),提升產品的抗跌落、抗(kàng)熱循環等性能。
隨著電子技術的不斷發展,芯片封裝形式日(rì)益多樣(yàng)化,對底部填充膠的(de)性能要求也越來越高。因此,了解芯片底(dǐ)部填充膠的種類以及如何進行選擇,對於電子封裝工程師(shī)和相關(guān)研究人員來說具有重要意義。根據其化學組成(chéng)和應用特點進行(háng)分(fèn)類,底部填充膠可以分為以下(xià)幾種類(lèi)型:
一、按固化方式分(fèn)類(lèi)
雙固化型底部填充(chōng)膠:可通過光照和(hé)溫度兩種方式進行固化,提供了更(gèng)靈活的(de)固(gù)化(huà)選擇。
熱(rè)固型底部填充膠:主要通過加熱(rè)實現固化,適用(yòng)於需要較高溫(wēn)度固化的場合。
光固化型底部填充膠:通過(guò)光照(如(rú)紫外線)實(shí)現固化。
二、按填充方式分類
邊緣底部填(tián)充法:僅在邊緣部分(fèn)進行填充,適用於對填(tián)充要求不高的場合。
完全底部填充法:將底部空隙(xì)完全填(tián)滿,提供最大的保護和支撐。
邊角綁(bǎng)定填充法:在邊角部分進(jìn)行特定的填充,以提供額外的支撐和穩定性。

三、按應用場景(jǐng)分類
倒(dǎo)裝芯片底部填充膠(Flip-Chip Underfill):
用於芯片與封裝基(jī)板互連凸(tū)點之間間隙的填充,此處的(de)精度一般(bān)為微米級,對於底(dǐ)部填充膠提出了很高的要求。使用方一般為先進封裝企業。
(焊)球柵陣列底部填充膠(BGA Underfill):
用於封裝基板與PCB印製電路板之間互連的焊(hàn)球之間的填充,焊球之間的間隙精度為毫米級,對底部填充膠要求(qiú)相(xiàng)對較(jiào)低。
四、按材料成(chéng)分分類
聚(jù)氨(ān)酯基底部填充膠:具(jù)有優異的機械性(xìng)能和化學穩定性,適用於需要承受高拉伸和(hé)壓縮力的(de)場合。
環氧樹(shù)脂基(jī)底部填充膠:這是(shì)最常見的(de)類型,環氧樹脂(zhī)具有優異的粘結(jié)性能和耐候性,適(shì)用於多種封裝場(chǎng)景。
其他(tā)材(cái)料基底部填充膠:如丙烯(xī)酸酯、丁基橡膠等,這些材料具有(yǒu)各自的特性,可以根據具體需求(qiú)進行選(xuǎn)擇。
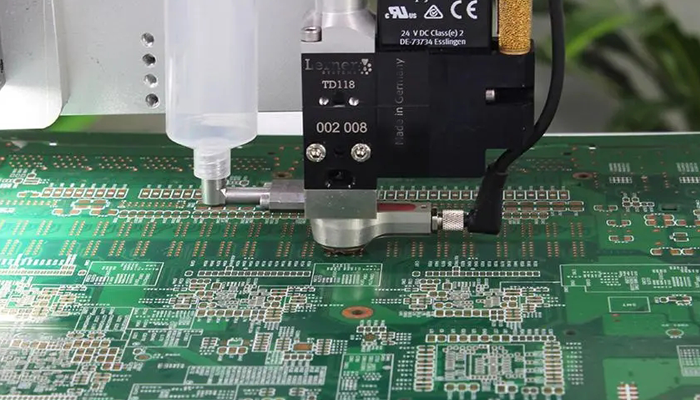
研泰(tài)化學深耕電子膠(jiāo)粘劑領域近二(èr)十(shí)載,針對芯片封裝膠推出了係列高性能產品,可(kě)以滿足不同應用場景的需求:
高可靠性環氧樹脂封裝膠:耐高溫、耐低溫、耐濕熱,適用於汽車電子、工業(yè)控製等嚴(yán)苛環境(jìng)。
低應力有機矽封裝膠:柔韌性好,能有效緩解應力,適用於功率(lǜ)器件、LED等對應力敏感的產品。
快速固化UV膠: 固化速度快,適(shì)用於需要快速封(fēng)裝的(de)場景。
芯片底部填充膠的種類繁多,選擇合適的底部填(tián)充膠取決於具體的應用要求,例如工作(zuò)溫度範圍、濕度(dù)環境、所需(xū)固化時間和成本等因素進行綜合考慮(lǜ)。此外,製造廠商也可根據自(zì)身的生產工藝來(lái)選擇最適合的產品。在(zài)選擇時,應該(gāi)評估產品的性能指標,包括流動性(xìng)、粘接力、熱膨脹(zhàng)係數匹配度等,同時也要考慮供應商的(de)技術(shù)支(zhī)持和服務(wù)質量。
研泰(tài)化學深(shēn)耕電子膠粘劑領域近二十載,可為用戶提供創新(xīn)、專(zhuān)業、定製化整體電子(zǐ)膠粘應用解決方案。在應用合作接洽中,研泰不僅提供優質的產(chǎn)品,更提供專業的技術支持和(hé)服務,會根據不同的產品結構,材質(zhì)以及生產工藝的要求為廠商定製膠黏(nián)劑解決方案!歡迎通過在線客服、網站留言、來電、郵件等方式聯係(xì)研泰化學(xué),將1V1免費為您(nín)提供(gòng)技術服務。